西電郝躍院士、張進成教授團隊---具有 RESURF 結構10 kV 耐壓的 β-Ga?O? 異質結場效應晶體管
由西安電子科技大學郝躍院士、張進成教授團隊在學術期刊 Science China Information Sciences 發布了一篇名為 Breakdown voltage over 10 kV β-Ga2O3 heterojunction FETs with RESURF structure(具有 RESURF 結構 10 kV 耐壓的 β-Ga2O3 異質結場效應晶體管)的文章。
1. 項目支持
本研究得到國家自然科學基金(Grant No. 62222407)、廣東省自然科學基金(Grant No. 2023B1515040024)和國家重點研發計劃(Grant No. 2021YFA0716400)的資助。
2. 背景
β-Ga2O3 作為一種超寬禁帶(~4.9 eV)半導體,因其極高的理論擊穿場強(達 8 MV/cm)和優異的功率性能(BFOM 高達 3000),在高壓電子器件領域備受關注。然而當前 β-Ga2O3 功率晶體管的擊穿電壓(BV)受限,現有終端設計多為一維(1D)結構,導致關斷態(off-state)電場分布不均,而且缺乏有效的二維(2D)電場調控手段。
該研究團隊提出,采用 RESURF(Reduced Surface Field),并引入 P-NiOX/N-β-Ga2O3 異質結結構(HJ-FET),可突破當前設計限制,提升耐壓能力。
3. 主要內容
該研究首次實現了在 β-Ga2O3 HJ-FET 中引入二維 RESURF 技術,具體策略包括構建 P-NiOX/N-β-Ga2O3 異質結。通過調控 P-NiOX 層厚度(tNiO),實現電場均勻分布。優化設計下,器件耐壓超過 10 kV,PFOM > 63 MW/cm2。驗證在 tNiO= 110 nm 時,P-NiOX 與 β-Ga2O3 同時耗盡,形成最理想的電場平坦區。提供理論推導與模擬支持,建立電荷密度與耗盡層厚度之間的解析關系。
4. 總結
研究團隊在 β-Ga2O3 晶體管中展示了 RESURF 技術,該技術有利于實現 E 平面度和 BV 容差。精心設計的電荷密度可確保 P-NiOX 和 N-β-Ga2O3 兩側同時完全耗盡。tNiO = 110 nm 的 RESURF P-NiOX/N-β-Ga2O3 HJ-FET 的 BV 超過 10 kV,PFOM 達到 63 MW/cm2。這些結果表明,β-Ga2O3 在大功率和高電壓領域具有相當大的功率潛力。
5. 圖文示例
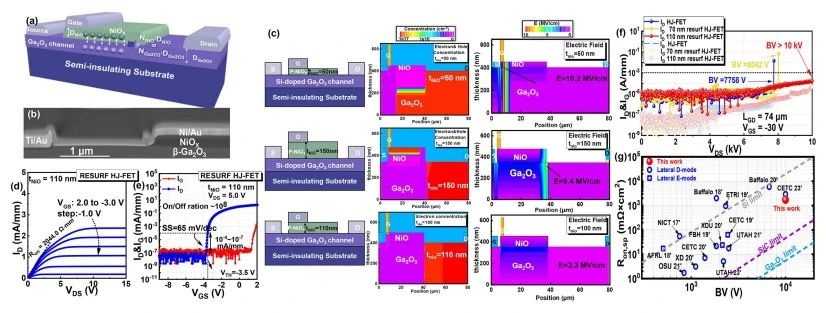
圖 1. (a) 具有代表性的 P-NiOX/N-β-Ga2O3 HJ-FET 的橫截面示意圖。(b) 具有代表性的 P-NiOX/N-β-Ga2O3 HJ-FET 的截面 SEM 圖像。(c) tNiO 為 50、150 和 110 nm 的 RESURF β-Ga2O3 HJ-FET 在 VDS 為 3000 V 時,β-Ga2O3 溝道中模擬載流子濃度和模擬三端離態電場分布的橫截面示意圖。(d) tNiO = 110 nm 的 RESURF P-NiOX/N-β-Ga2O3 HJ-FET 的輸出和 (e) 對數尺度傳輸特性。(f) LGD = 74 µm 時器件的三端擊穿特性。(g) 近期先進的 β-Ga2O3 晶體管功率性能基準。
DOI:
doi.org/10.1007/s11432-024-4332-4
本文轉發自《亞洲氧化鎵聯盟》訂閱號
